
Институт микроэлектроники Китайской академии наук добился нового прогресса в подавлении инфракрасного излучения от коллекторов EUV-литографии.
2025-07-22
Технология литографии в экстремальном ультрафиолетовом диапазоне (EUVL) является ключевым техническим направлением для развития технологий производства полупроводников. Современная система источников света LPP-EUV бомбардирует плазму олова инфракрасным лазером (ИК) с длиной волны 10,6 мкм для генерации экстремального ультрафиолетового излучения, которое фокусируется в промежуточном фокусе (ПЧ) собирающим зеркалом. Однако, если остаточное инфракрасное излучение системы попадает в экспонирующую оптическую систему, оно создает ненужную тепловую нагрузку, которая влияет на стабильность и качество экспонирования литографической системы. Поэтому эффективное подавление инфракрасного излучения имеет решающее значение для обеспечения производительности литографической машины.
В настоящее время промышленность обычно интегрирует структуры фильтров спектральной очистки (SPF) на поверхности собирающих EUV-зеркал для фильтрации энергии инфракрасного излучения, но существующий метод оценки опирается только на одну физическую величину дифракционной эффективности для оценки эффекта подавления, что не обеспечивает полноты.

![Рисунок 1 (а) Принципиальная схема собирающего зеркала интегрированных SPF, (б) распределение инфракрасной энергии на поверхности диафрагмы в промежуточном фокусе, (в) Принципиальная схема оптического пути системы LPP-EUV]
Недавно группа под руководством Ци Юэцзина, исследователя из Института микроэлектроники Китайской академии наук, совершила прорыв в этой области. Группа предложила теоретическую модель коэффициента подавления инфракрасного излучения (IRSR), основанную на линейной плотности потока излучения. Эта модель позволяет интегрировать и уменьшать размер потока инфракрасного излучения собирающего зеркала, эффективно интегрируя множество ключевых факторов, таких как распределение энергии источника света, геометрическая форма собирающего зеркала, отражательные характеристики многослойной пленки и дифракционная эффективность решетки, и реализует точный анализ механизма вклада и количественного веса каждого фактора в локальный и глобальный IRSR собирающего зеркала.
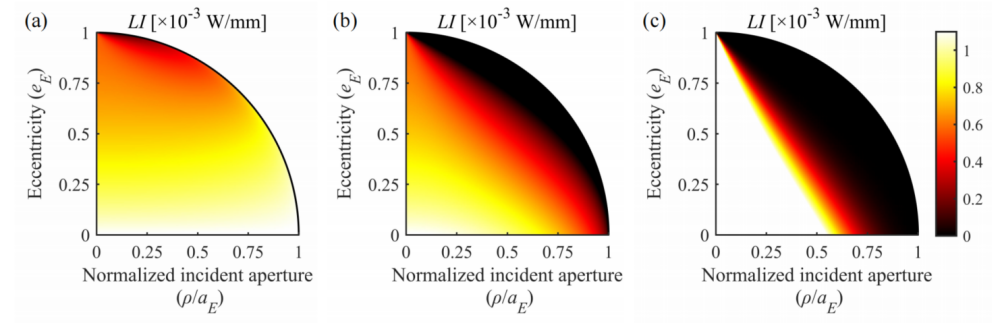
![Рисунок 2 Изменение линейной плотности потока излучения на поверхности коллектора с нормированной апертурой падения и эллиптичностью при (а) равномерном распределении, (б) ламбертовском распределении и (в) гауссовском распределении источников инфракрасного излучения]
По сравнению с существующими методами оценки, основанными только на одной физической величине, эта модель представляет собой многомерную комплексную аналитическую структуру, которая подтверждает, что глобальный IRSR фактически представляет собой взвешенный гармонический средний интеграл локального IRSR, где весовая функция представляет собой линейную плотность потока излучения на поверхности коллектора. Данное исследование заложило прочную теоретическую основу для согласованной оптимизации коллектора и SPF, а также для точного измерения IRSR.

![Рисунок 3. Линейная разность потоков излучения падающего и дифрагированного инфракрасного света нулевого порядка вдоль меридионального направления собирающего зеркала в условиях (а) равномерного распределения, (б) ламбертовского распределения и (в) гауссовского распределения источников инфракрасного излучения]